文章来源:Jeff’s Chip World
原作者:Jeff’s Chip World
在功率MOSFET器件的设计和选择中,单脉冲雪崩能量(EAS)是一个至关重要的参数。它量化了器件在极端过压条件下单次突发承受雪崩能量的能力,单位为焦耳(J)。 EAS值越大,设备在遇到瞬时电压尖峰时损坏的可能性就越小。
EAS的基本概念和重要性
EAS代表单次雪崩能量,用于测量MOSFET在漏源(DS)端承受过压应力的能量容限。这个参数的形象描述来自于测试过程:当电压上升到临界点时,电流会迅速崩溃,类似于雪崩现象。在器件手册中,EAS为设计者提供了明确的耐受能力参考,是评估器件可靠性和电路安全性的关键指标之一。
在实际应用中,EAS主要描述单个雪崩事件。设备手册中还有一个参数EAR(可重复雪崩能量)。其极限值通常比EAS小得多,对芯片的长期可靠性影响较小。因此,电路设计应重点考虑和避免高能EAS事件的发生。
EAS的测试原理及评价方法
EAS 测试通常基于感性负载开关电路。基本原理是:栅极信号控制MOSFET的导通,对串联电感充电;当MOSFET关断时,储存在电感中的能量将通过器件释放,迫使漏源电压VDS上升,并可能超过其击穿电压BV_DSS,进入雪崩状态。测试直至设备失效,并根据失效前的电流等参数计算消耗的能量。
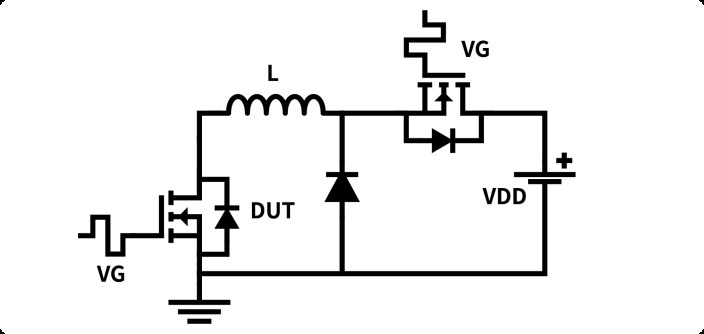
典型的测试方法是设置总线电压V_DD,在栅极和源极之间施加脉冲电压(例如10V)来开启器件,然后在电感电流上升到特定值I_AS后关闭器件。电感器能量释放导致雪崩,并测量或计算EAS。需要注意的是,准确的EAS计算应该使用实际测试中测得的BV_DSS值,而不是直接使用手册标称值,并且不同厂家的测试条件可能有所不同。因此,仅根据说明书中的数据无法直接比较不同设备的EAS能力。
影响EAS的关键因素
EAS的大小不是一个固定值。它受芯片温度、测试电路电感、电流等多种因素影响。
1、温度的影响:EAS造成的损坏本质是芯片过热。芯片的初始结温(Tj)直接影响其EAS能力。 —— 初始温度越高,能承受的EAS能量越小。在雪崩过程中,能量转化为热量,导致温度升高。其关系可以表示为:在电流恒定的情况下,温升与吸收的能量成正比。
2、电感和电流的影响:手册中给出的EAS值通常对应于特定的测试电流I_D。 EAS 能量与电感器中存储的能量直接相关。根据能量公式,如果在温升和最大雪崩电压不变的情况下增大电感,则为了达到相同的温升,允许的雪崩电流会减小。综合起来,如果电感增加数倍,EAS能量会增加,但同时雪崩电流会减少。
EAS的故障模式和机制
当雪崩能量超过器件极限时,就会造成破坏性失效。有两种主要模式。
首先是寄生二极管雪崩烧毁。 MOSFET内部有一个体二极管(寄生二极管)。当器件关断、感性负载续流时,寄生二极管承受反向电压。如果电压尖峰使其进入雪崩击穿状态,大电流和高电压会在芯片内部产生大量热量。如果热量不能及时散发,设备就会因过热而烧毁。
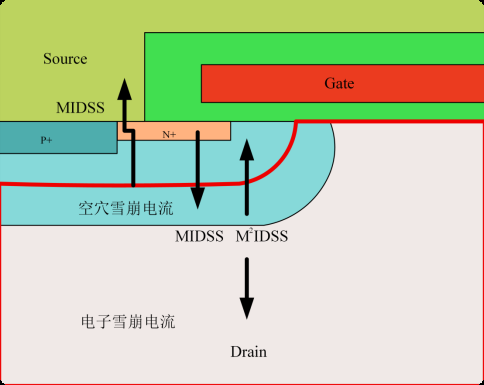
第二个是当寄生双极晶体管(BJT) 导通时。 MOSFET结构内部还有一个由源极、P基极区和N漂移区形成的寄生NPN晶体管。通常情况下它是关闭的。当寄生二极管发生雪崩击穿时,流经P基区横向电阻RB的电流增大,可能导致RB两端的压降超过寄生BJT的导通电压(VBE),导致其导通。一旦寄生BJT导通,就会形成大电流沟道,导致MOSFET失效、短路。为了抑制这种故障模式,现代MOSFET 设计努力降低RB 电阻。目前,大多数EAS故障案例仍然以寄生二极管雪崩击穿和发热为主。
EAS 烧毁点通常集中在栅极焊盘(PAD) 附近。这是因为靠近栅极的单元具有较小的寄生参数和更快的关断速度。在雪崩事件中,细胞将承受压力并先于其他区域崩溃。
电路设计中的保护措施
为了防止EAS事件损坏设备,可以在电路设计中采取保护措施。例如,在变压器或感性负载两端并联一个RCD吸收回路,以钳位和吸收反向尖峰电压。 RC 缓冲电路也可以并联在MOSFET 的漏极和源极之间。另外,适当增加栅极串联电阻可以减慢关断速度(抑制dv/dt),从而减少电压尖峰,但由此带来的关断损耗增加需要权衡。优化PCB 布局、加厚大电流路径和缩短走线有助于减少线路寄生电感并减少源头的电压尖峰能量。
标题:功率MOSFET器件的单脉冲雪崩能量参数解读
链接:https://yqqlyw.com/news/sypc/70953.html
版权:文章转载自网络,如有侵权,请联系删除!